0引言
芯片是现代计算机?电子产品等工业产业的核心部件之一,而封装技术就是将内部芯片包裹起来,以避免芯片与外界接触,防止外界对芯片的损害的一种工艺技术?空气中的杂质和不良气体,乃至水蒸气都会腐蚀芯片上的精密电路,进而造成电学性能下降?不同的封装技术在制造工序和工艺方面差异很大,封装后对内部芯片自身性能的发挥也起到至关重要的作用?
1现有封装技术分析
目前电子产品越来越小型化,封装越来越片式化,TO-252封装以其外形尺寸小?功率大而得到越来越广泛的应用,然而其封装中容易出现分层现象,在不同的介质之间存在间隙和水汽,当产品工作发热时,水汽膨胀,使得产品失效,甚至爆炸?
本文针对这些问题研究了一种新型的封装硅芯片的方法,通过优化引线框架结构,在载芯板上增加楔形盲孔,提高引线框架和塑封料之间的结合性能,有效地解决了分层问题?
2新型封装技术改进
2.1引线框架的制作
引线框架的作用在于实现芯片内部电路引出段与外部电路的电气连接,形成欧姆通路,其材质为铜?铜合金或者铁?铁基镍合金等金属材料?
图1为新的引线框架,它包含承载待封装芯片的载芯板?引脚和多个载芯板之间的连接筋,其中a引脚连接着载芯板,通过连接筋,在引线框架上可以连接多个载芯板?在载芯板的板面上有若干个凹坑,凹坑在横向与纵向上均呈均匀式分布,凹坑的形状为楔形盲孔,其坑口面积大于坑底面积,且坑口和坑底的形状都为矩形,坑口边长为0.08mm~0.12mm,坑底边长为0.04mm~0.07mm,深度为0.03mm~0.1mm?

2.2塑封料的选择
选用环氧树脂作为塑封料,它是一种热固性化学材料,主要由环氧树脂?硬化剂?添加剂等混合后加工形成,视封装工艺要求各成分比例略有不同?为了防止产品回潮,塑封料中不含任何卤系元素?
3优化理论分析
3.1问题分析
TO-252封装中常见的分层类型如表1所示?

以上四种异常都是由两种材料间的结合力不够引起的,其优化方法一方面是通过更换新型材料,提高不同材质间的结合强度;另一方面是优化引线框架结构,通过冲压形成均匀的楔形凹坑,增加塑封料和不同材料之间的结合面积,进而增加两部分的结合强度?
由表2可见,铁镍材料的热膨胀系数较小,铜及铜合金材料膨胀系数较大?铜质引线框架与常用塑封料的热膨胀系数较为接近,但与硅芯片膨胀系数相差较大,在不同的温度条件下,由于膨胀系数不同,还需要优化引线框架的结构?

3.2结构优化
新引线框架结构主要做了以下几方面改进:(1)在载芯板上增加楔形凹坑,以增大电子元件引脚与塑封料?塑封料与载芯板之间的结合面积,共同作用使得载芯板与芯片的结合强度大大增加;(2)针对塑封料与框架结合不牢固的问题,在载芯板上增设锁定孔,相当于在塑封料与框架间加入榫卯结构,把塑料与框架紧钉在一起;(3)在引脚处加入密封槽,保证产品封装后的密封性;(4)优化后的引线框架调整了结构尺寸,其中装片面积比原有框架增加65%,可以装载更大面积的芯片,也更有利于产品散热;压脚面积比原有框架增加近50%,允许焊接更粗的线径,满足大电流产品的封装需求,图2是框架改进前后的对比?
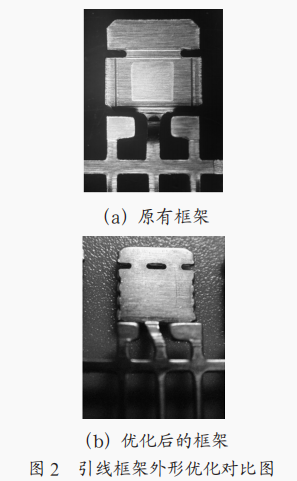
3.3模具优化
原有模具在脱模时,由于模具与管体正面塑料之间产生的粘结力,会增加封装层合之间的内应力,导致因脱模而产生分层,因此对模具进行了相应的优化:(1)改变上下模位置,减少脱模时对管体正面塑料的拉扯作用,减少应力;(2)在每个管体的型腔中增加了一根顶针,脱模时通过顶针给予管体一个力的作用,使之迅速与模具脱离,减少两者粘力的作用,如图3所示?
4改进的封装流程步骤详述
第一步:使用新的框架进行粘片?粘片之前一般对引线框架在250∽350℃下进行15s∽30s预热处理,其益处在于粘片温度普遍在300∽400℃,如果引线框架从室温骤然升到400℃,载芯板会产生很大的应力,容易引起芯片开裂?
第二步:采用焊锡点焊料,或者通过融化硅芯片背面的金层来连接硅芯片与载芯板?
第三步:采用超声波焊接,通过内引线将硅芯片电极与引线框架对应的引脚连接起来?
第四步:塑封,将引线框架放入模具中,在100℃-180℃温度下预热引线框架8min-12min,用液压机将塑封料压入模具,从而将芯片内引线?引线框架的三个引脚a?b?c的端头密封起来?
第五步:密封完毕后,让产品在200℃-250℃温度下进行热处理2h-3h,释放其内应力?
第六步:对引线框架的引脚a?b?c经行电镀,使各引脚均匀镀上一层锡?
第七步:分离成型,切掉引线框架上的连接筋,得到具有独立功能的产品?
第八步:由于去除连接筋时也会产生内应力,管脚根部的塑封料容易产生分层现象,因此再让产品在150℃-200℃温度下退火3h-12h,释放管脚内应力?
5对改进方法的可靠性进行测试
5.1无损检测
通过对框架和模具进行改进,产品的密封性得到很大的改善,使用超声波探伤技术,对密封后的引线框架进行C-SAM检测,如图4(顶底部分表示有塑料体和框架分层)?可以明显地看出经过模具和框架结构的优化,组件内部的芯片粘接失效?分层?裂纹?夹杂物?空洞等可能的分层现象大大减少,证明上述优化工作产生了良好的效果?
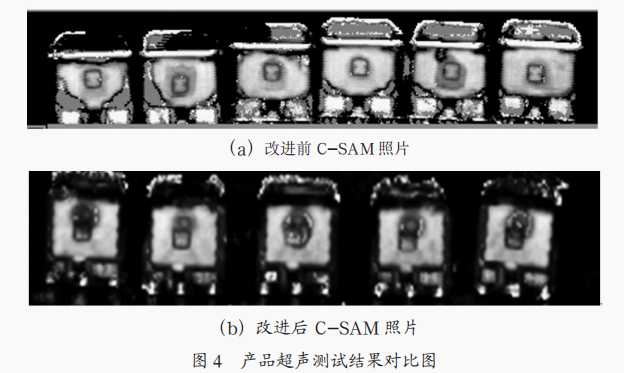
5.2试流测试
针对改进后的封装技术,通过开展试流测试,来检验新型封装产品在防止芯片与框架分层的优化效果,具体实验数据如表3所示,从中可以看出改进后的产品性能良好,成品率稳定?

6结论
本文通过优化TO-252框架结构,提出了一种能够提升封装芯片结合强度的方法,可以有效地解决半导体器件分层问题?主要优化措施包括:(1)对引线框架结构进行了重新设计,加入多个楔形盲孔结构,增大了部件之间有效接触面积,有利于提升封装部件的结合强度与密封性能;(2)优化模具及相关工艺,新的塑封模具在型腔里增加了顶针孔,比旧模具更容易脱模,也减少了脱模时的拉扯力,减小塑封料与框架间分层的可能性;(3)提出了一套完整的生产工艺,能够有效地减少芯片封装过程中产生的应力集中现象,对于行业内提高芯片封装质量具有较高的参考价值?
本文来源:现代信息科技 版权归原作者所有,转载仅供学习交流,如有不适请联系我们,谢谢。



